Dual Beam FIB (FEI Helios 600 NanoLab)
¤ Présentation
¤ Caractéristiques de l’appareil
¤ Exemples de clichés
La station Dual beam FIB (FEI Helios 600 NanoLab) est utilisée pour la préparation par micro-usinage ionique de lames minces pour l’observation au MET.
L’appareil est composé d’une colonne électronique et d’une colonne ionique (ions Ga+). La source d’électrons sert à imager la surface de l’échantillon selon le même principe qu’un microscope électronique à balayage conventionnel. La source d’ions permet de préparer des lames minces dans une zone localisée de l’échantillon pour des observations au MET.
L’avantage de cette technique de préparation par FIB par rapport aux techniques conventionnelles est multiple :
- la zone à amincir est choisie avec une précision de quelques nanomètres et peut être orientée dans n’importe quelle direction
- insensibilité aux duretés relatives et à la composition des matériaux
- épaisseur constante de la lame mince

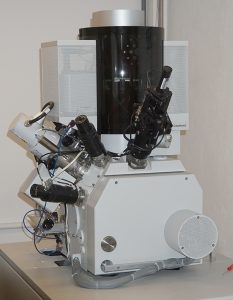
Ce type d’instrument permet également de caractériser en 3D un échantillon en alternant coupes FIB et images MEB. Cette méthode de tomographie permet d’accéder à des volumes de quelques microns à quelques dizaines de microns de côté avec une résolution pouvant aller jusqu’à quelques nanomètres.
Optique ionique
Résolution : 5,0 nm @ 30 kV
Courant de faisceau : de 1,5 pA à 20 nA
Tension d’accélération : 0,5 kV à 30 kV
Source Ga LMIS
Injecteurs Pt, W, Insulator (SiOx)
Optique électronique
Résolution : 0,9 nm à 15 kV, 1,4 nm à 1 kV
Courant de faisceau : < 22 nA
Tension d’accélération : de 350 V à 30 kV
Source FEG Schottky
Détecteur Everhart- Thornley (ETD) pour l’imagerie conventionnelle
Détecteur d’électrons secondaires et d’électrons rétrodiffusés in lens (TLD) pour l’imagerie haute résolution.
Système Omniprobe 100.7 pour la récupération in-situ d’échantillons TEM.
-
Analyse par tomographie FIB/SEM du cœur d’une fibre optique en silice contenant des nanoparticules d’oxyde de lanthane dopées d’ions luminescents. Insert : volume reconstruit de 5µm x 5µm x 0.5µm (seules les particules sont représentées). Vermillac et al.,JACS 100 (2017) 1814
-
Préparation par FIB de nanofils en section transverse. Haut : image MEB tiltée de la surface des nanofils. Bas : Portion d’une lame TEM découpée au centre d’une rangée de nanofils (zone encadrée en vert sur l’image du Haut)